
高速点胶机通用工艺有:底部填充、FPC封装、手机边框点热熔胶、SMT点红胶、LED lens点胶、IC边缘封装等。

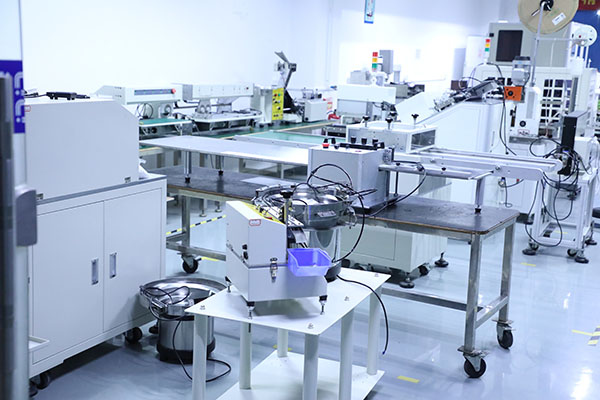

几乎所有这几种封装材料都需要很长的固化时间,所以用在线式连续生产的固化炉是不实际的,平时大家经常使用“批次烘炉”,但垂直烘炉的技术也趋于完善,尤其是高速点胶机在加热曲线比回流炉简单时,垂直烘炉完全能够胜任。垂直烘炉使用一个垂直升降的传送系统作为“缓冲与累加器”,每一块PCB都须通过这一道工序循环。这样的结果就是能保证足够长的固化时间,而同时减少了占地面积。
以上是高速点胶机厂家总结的点胶固化工艺解析,如果大家有更好的想法或意见,欢迎提出一起探讨!